日(ri)前華(hua)為公(gong)布(bu)了和(he)哈(ha)工大聯(lian)合(he)申(shen)請(qing)的(de)全(quan)新芯片專(zhuan)利(li)——“金剛石芯片(pian)”,這(zhe)標(biao)誌(zhi)著(zhu)華為在集(ji)成電路(lu)技(ji)術(shu)領域(yu)的領先(xian)地(di)位。金剛(gang)石材(cai)料因其(qi)硬(ying)度、穩(wen)定(ding)性和熱導性,被(bei)視(shi)為理想的芯片製(zhi)造(zao)材料(liao)。與傳統矽(xi)芯片相(xiang)比(bi),金剛石芯片(pian)在運算效率和穩定性方麵有顯著優勢。哈爾濱工(gong)業(ye)大(da)學(xue)采(cai)用石墨烯(xi)散熱技術,解(jie)決(jue)了(le)高速(su)運(yun)行芯片的散熱(re)問(wen)題。

(圖文部分(fen)來源(yuan)網(wang)絡(luo),侵(qin)刪(shan)下同(tong))
本次(ci)新專利技術將可(ke)能(neng)顛(dian)覆(fu)傳統(tong)芯(xin)片製造工藝,為未(wei)來電子產(chan)品(pin)的性能和功耗(hao)帶來(lai)更(geng)革命性進(jin)展。然(ran)而,美國(guo)對(dui)這一技術突破表示擔(dan)憂(you),認(ren)為它可能影響美國的國家安(an)全和產業利益。
據(ju)悉(xi),該專利是“一種(zhong)基於(yu)矽和金剛石的三維(wei)集成(cheng)芯片的混(hun)合鍵(jian)合方法(fa)”。新(xin)技術實現了以Cu/SiO2混合鍵合為(wei)基礎(chu)的矽/金剛石三維異(yi)質集成,未來可能應(ying)用(yong)在自(zi)家(jia)麒(qi)麟(lin)芯片中。
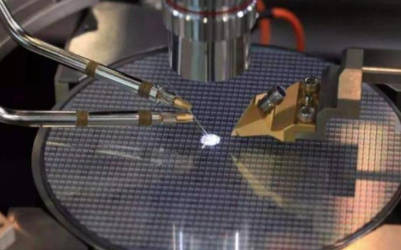
金剛石(shi)作為一種極(ji)硬的材料,具有出(chu)色(se)的機(ji)械(xie)性能、化學穩定性以(yi)及熱導(dao)性,非(fei)常(chang)適合用於高端(duan)芯片的製造。相比矽材料,金剛石芯片在運算(suan)效率和穩定性方麵具有天(tian)然的優勢。哈爾(er)濱(bin)工業大學材料學院(yuan)在這一項(xiang)目(mu)中,成功應用了世(shi)界(jie)首(shou)創的石墨(mo)烯基(ji)散熱技術,大幅(fu)提(ti)升(sheng)了芯片的散(san)熱效果(guo),解決了高(gao)速運算芯片的熱量(liang)聚(ju)集難(nan)題(ti),使芯片可以長(zhang)期(qi)穩定運行。

從技術視角(jiao)看(kan),金剛石芯片的誕(dan)生(sheng)是集成電路發展(zhan)史(shi)上的重要(yao)裏(li)程(cheng)碑。其卓(zhuo)越(yue)的熱導能力(li)使(shi)之成為製造高速、高穩定性芯片的理(li)想(xiang)平(ping)台(tai)。石墨烯散熱技術的應用也(ye)徹(che)底(di)解決了高端芯片散熱的瓶(ping)頸(jing)。這項突破(po)不僅(jin)讓(rang)芯片性能、速度和穩定性達(da)到(dao)更高水(shui)準(zhun),也為未來人工智(zhi)能時(shi)代打(da)下(xia)堅(jian)實基礎。
該新專利的核(he)心(xin)技術在於,突破了現有三維集成以矽為襯底的基礎,利用金剛石作為連接(jie)材料,實(shi)現(xian)矽基半導體與金剛石之(zhi)間的無(wu)縫(feng)融合。這種全新的鍵合方式(shi)不僅可以提高芯片的集成度(du),還能降低製造成本,進而大幅提升電子產品性能。
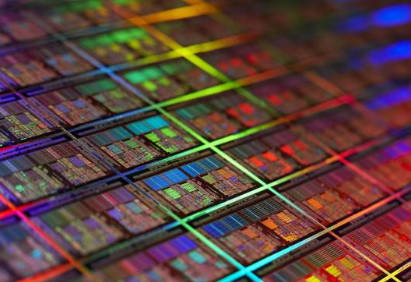
由(you)於金剛石具(ju)有高導熱性和高硬度的特(te)點(dian),同時也是(shi)寬(kuan)禁(jin)帶(dai)半導體(ti),具備(bei)擊(ji)穿(chuan)場(chang)強(qiang)高、載(zai)流子(zi)遷(qian)移(yi)率高、抗(kang)輻(fu)照(zhao)等(deng)優點,因(yin)此(ci),新技術還(hai)有助(zhu)於緩(huan)解電子產品發熱問題,既(ji)降(jiang)低功耗,又(you)延長壽(shou)命(ming)。
三維集成技術通(tong)過(guo)在垂(chui)直(zhi)芯片方向上(shang)采用矽通孔(kong)(TSV)互連(lian)方式實現上下層(ceng)之間的通信(xin),能實現多芯片、異質芯片集成等多層堆(dui)疊(die)的三維(3D)集成,具備功(gong)能化(hua)程度高、工藝兼(jian)容(rong)性好(hao)、成本較(jiao)低(di)等優勢逐(zhu)漸(jian)成為了半(ban)導體產業發展的主(zhu)流(liu)方向(xiang)。

然而(er),隨(sui)著集成密(mi)度不斷(duan)升高及(ji)特征(zheng)尺(chi)寸(cun)不斷縮(suo)小(xiao),電子芯片的熱管(guan)理麵臨(lin)極大的挑戰(zhan)。芯片內(nei)部熱積(ji)累(lei)難以向封(feng)裝表(biao)層散熱片傳(chuan)遞(di),導致(zhi)內部節(jie)溫(wen)突升,嚴重(zhong)威(wei)脅芯片性能、穩定性和使用壽命。
通過Cu/SiO混合鍵合技術將(jiang)矽基與金剛石基襯底材料進行(xing)三維集成能夠(gou)融(rong)合矽基半導體器件成熟(shu)的工藝及產線(xian)、生產效(xiao)率高、成本(ben)較低的優勢及金剛石極高的發展潛(qian)力,為三維集成的矽基器(qi)件提供(gong)散熱通道(dao)以提高器件(jian)的可靠(kao)性。
但(dan)是現有的Cu/SiO混合鍵合技術多以矽為襯(chen)底進行集成,其集成工藝(yi)不完(wan)全適用於金剛石,而本發(fa)明就(jiu)針(zhen)對性的解決了現有的Cu/SiO混合鍵合樣(yang)品的製備不適(shi)用於金剛石晶(jing)片表麵(mian)Cu/SiO混合鍵合樣(yang)品的製備;現有Cu/SiO混合鍵合工藝對於具備粗(cu)糙(cao)表麵的矽/金剛石三維集成適用性較差(cha);高溫鍵合工藝容易(yi)增大芯片間熱失(shi)配(pei),致使熱應力增(zeng)加(jia),從(cong)而影(ying)響(xiang)鍵合強度,不適用於矽/金剛石的三維異質(zhi)集成等問題中的至(zhi)少(shao)一種。
該(gai)發明(ming)實現了以Cu/SiO2混合鍵合為基礎的矽/金剛石三維異質集成。同時,華為本次發布的新型(xing)三維集成芯片采用了獨(du)特的納(na)米(mi)加工技術,使得(de)芯片內部(bu)的電路布局(ju)更加緊(jin)湊(cou),還通過先進的封裝(zhuang)技術實現了芯片與(yu)外(wai)圍(wei)電路的高效互(hu)聯,進一步(bu)提升整(zheng)體性能。

(哈爾濱工業大學圖(tu))
業內分析(xi)人(ren)士(shi)表示(shi),這種基於矽和金剛石的三維集成芯片的混合鍵合方法是國內芯片製造領(ling)域的一個(ge)突(tu)破,同時也為技術封鎖(suo)下的國產芯片產業打了一劑(ji)強心針!華為和哈爾濱工業大學的強強聯合未來將會(hui)有(you)更多技術突破,為國產芯片的創(chuang)新和發展提供強勁(jin)動(dong)力。





 點擊谘詢
點擊谘詢
 客服電話:0755-82789005
客服電話:0755-82789005